JAJS629Q February 2000 – January 2023 LM1117
PRODUCTION DATA
- 1 特長
- 2 アプリケーション
- 3 概要
- 4 改訂履歴
- 5 デバイス比較表
- 6 ピン構成および機能
- 7 仕様
- 8 詳細説明
- 9 アプリケーションと実装
- 10デバイスおよびドキュメントのサポート
- 11メカニカル、パッケージ、および注文情報
パッケージ・オプション
メカニカル・データ(パッケージ|ピン)
サーマルパッド・メカニカル・データ
- KTT|3
発注情報
9.5.1.1 ヒートシンク要件
集積回路が大電流で動作する場合、接合部温度が上昇します。許容可能な性能と信頼性を実現するには、熱限界を定量化する必要があります。この制限は、半導体の接合部から動作環境までの一連の温度上昇を含む、個々の部品を加算することで決定されます。伝導熱伝達の 1 次元定常状態モデルを、「図 9-9」に示します。デバイスの接合部で発生した熱は、ダイからダイの接続パッドに流れ、リード・フレームを通って周囲のケース材質、プリント基板、最終的に周囲の環境に放出されます。熱抵抗に影響を及ぼし、結果としてヒートシンクの必要性に影響する可能性がある変数のリストを、以下に示します。
| RθJC (部品変数) | RθJA (アプリケーション変数) |
|---|---|
| リード・フレームのサイズと材質 | 取り付けパッドのサイズ、材質、位置 |
| 導通ピンの数 | 取り付けパッドの配置 |
| ダイ・サイズ | PCB のサイズと材質 |
| ダイ取り付け材料 | 配線の長さと幅 |
| 成形コンパウンドのサイズと材料 | 隣接する熱源 |
| 空気の量 | |
| 周囲温度 | |
| 取り付けパッドの形状 |
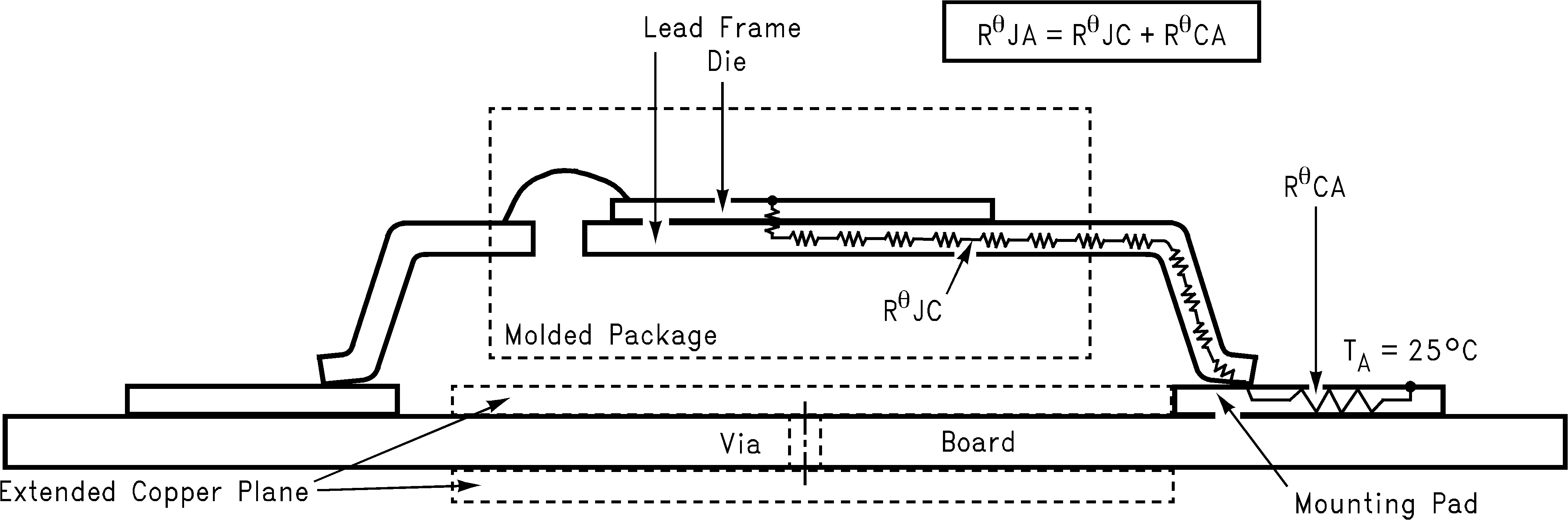
LM1117 レギュレータには、過熱からデバイスを保護するためのサーマル・シャットダウン機能が内蔵されています。可能なすべての動作条件において、LM1117 の接合部温度は 0℃~+125℃の範囲内にする必要があります。アプリケーションの最大消費電力と最大周囲温度によっては、ヒートシンクが必要になる場合があります。ヒートシンクが必要かどうかを判定するには、レギュレータによって消費される電力 PD を以下のように計算する必要があります。
回路に存在する電圧と電流を、「図 9-10」に示します。
 図 9-10 消費電力の図
図 9-10 消費電力の図次に計算が必要なパラメータは、最大許容温度上昇 TR(max) です。
ここで
- TJ(max) は、アプリケーションで発生する最大許容接合部温度 (125℃)
- TA(max) は、アプリケーションで発生する最大周囲温度
TR(max) と PD の計算値を使用して、接合部から周囲への熱抵抗 (RθJA) の最大許容値を計算できます。
θJA の最大許容値については、「Topic Link Label7.4」の表を参照してください。
設計のための資料として、さまざまなヒートシンク面積における SOT-223 と TO-252 の θJA の値を、「表 9-2」に示します。「図 9-11」と「図 9-12」は、「表 9-2」に記載されているものと同じテスト結果を反映しています。
「図 9-13」と「図 9-14」に、SOT-223 および TO-252 デバイスの最大許容消費電力と周囲温度との関係を示します。「図 9-15」と「図 9-16」に、SOT-223 および TO-252 デバイスの最大許容消費電力と銅箔部分 (in2) との関係を示します。SOT-223 および TO-252 パッケージで使用する電力拡張技法については、AN1028 を参照してください。
『AN-1187 リードレス・リードフレーム・パッケージ (LLP)』アプリケーション・ノートでは、WSON の熱性能と消費電力の改善について説明しています。
| レイアウト | 銅箔部分の面積 | 熱抵抗 | ||
|---|---|---|---|---|
| 上面 (in2)(1) | 底面 (in2) | (θJA、℃/W) SOT-223 | (θJA、℃/W) TO-252 | |
| 1 | 0.0123 | 0 | 136 | 103 |
| 2 | 0.066 | 0 | 123 | 87 |
| 3 | 0.3 | 0 | 84 | 60 |
| 4 | 0.53 | 0 | 75 | 54 |
| 5 | 0.76 | 0 | 69 | 52 |
| 6 | 1 | 0 | 66 | 47 |
| 7 | 0 | 0.2 | 115 | 84 |
| 8 | 0 | 0.4 | 98 | 70 |
| 9 | 0 | 0.6 | 89 | 63 |
| 10 | 0 | 0.8 | 82 | 57 |
| 11 | 0 | 1 | 79 | 57 |
| 12 | 0.066 | 0.066 | 125 | 89 |
| 13 | 0.175 | 0.175 | 93 | 72 |
| 14 | 0.284 | 0.284 | 83 | 61 |
| 15 | 0.392 | 0.392 | 75 | 55 |
| 16 | 0.5 | 0.5 | 70 | 53 |
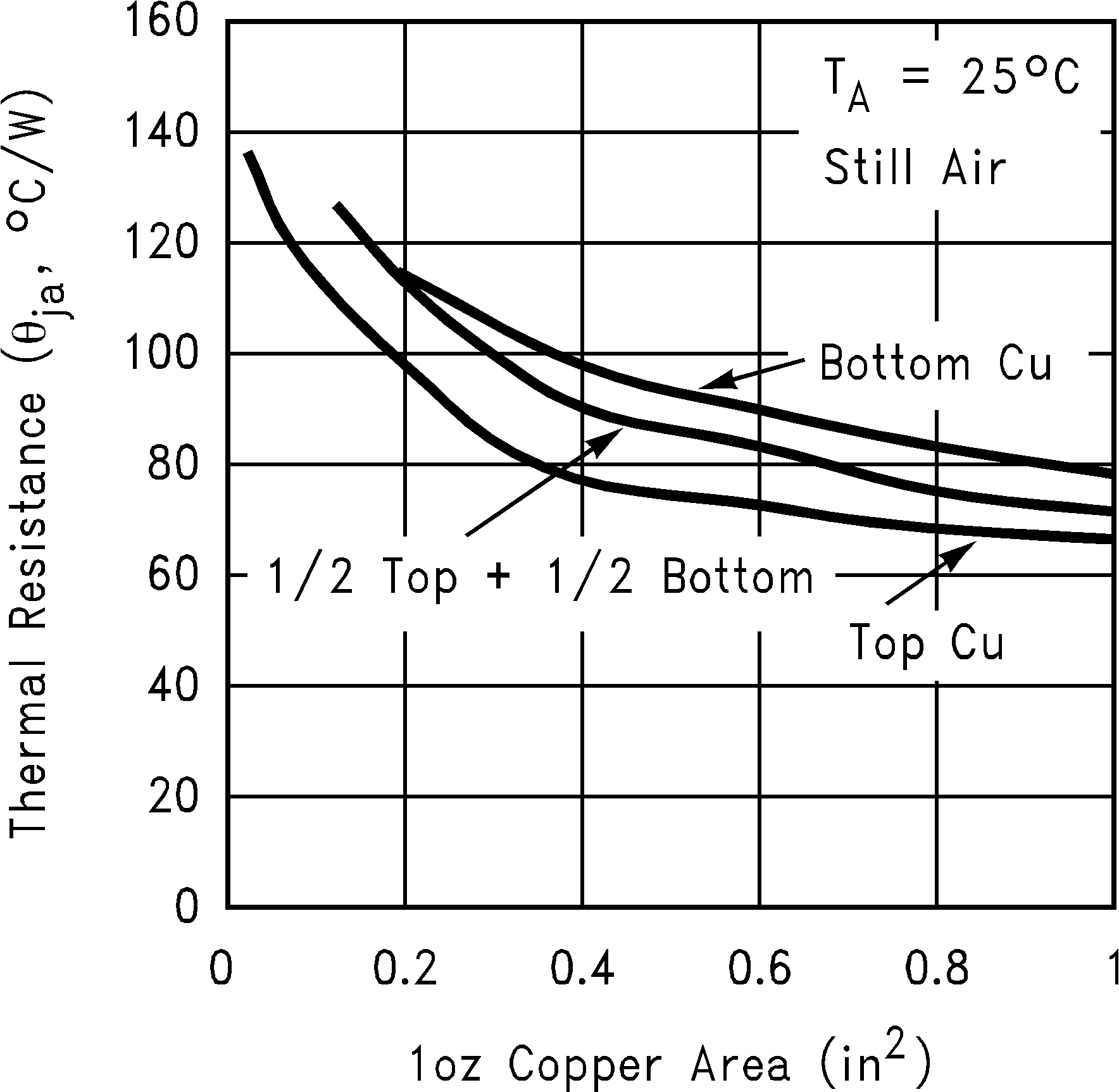 図 9-11 SOT-223 で銅箔部分が 1 オンスのときの RθJA
図 9-11 SOT-223 で銅箔部分が 1 オンスのときの RθJA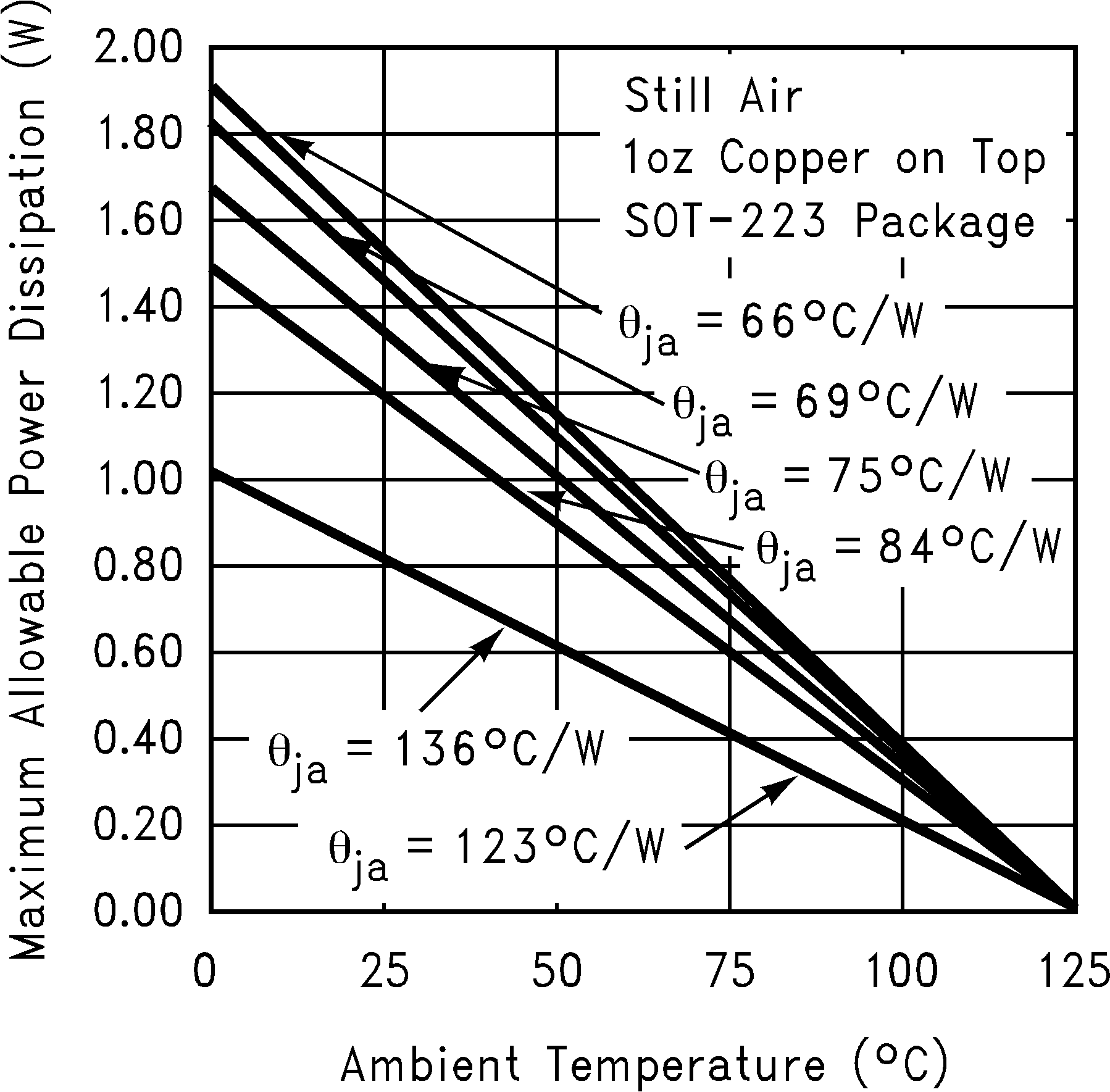 図 9-13 SOT-223 の最大許容消費電力と周囲温度との関係
図 9-13 SOT-223 の最大許容消費電力と周囲温度との関係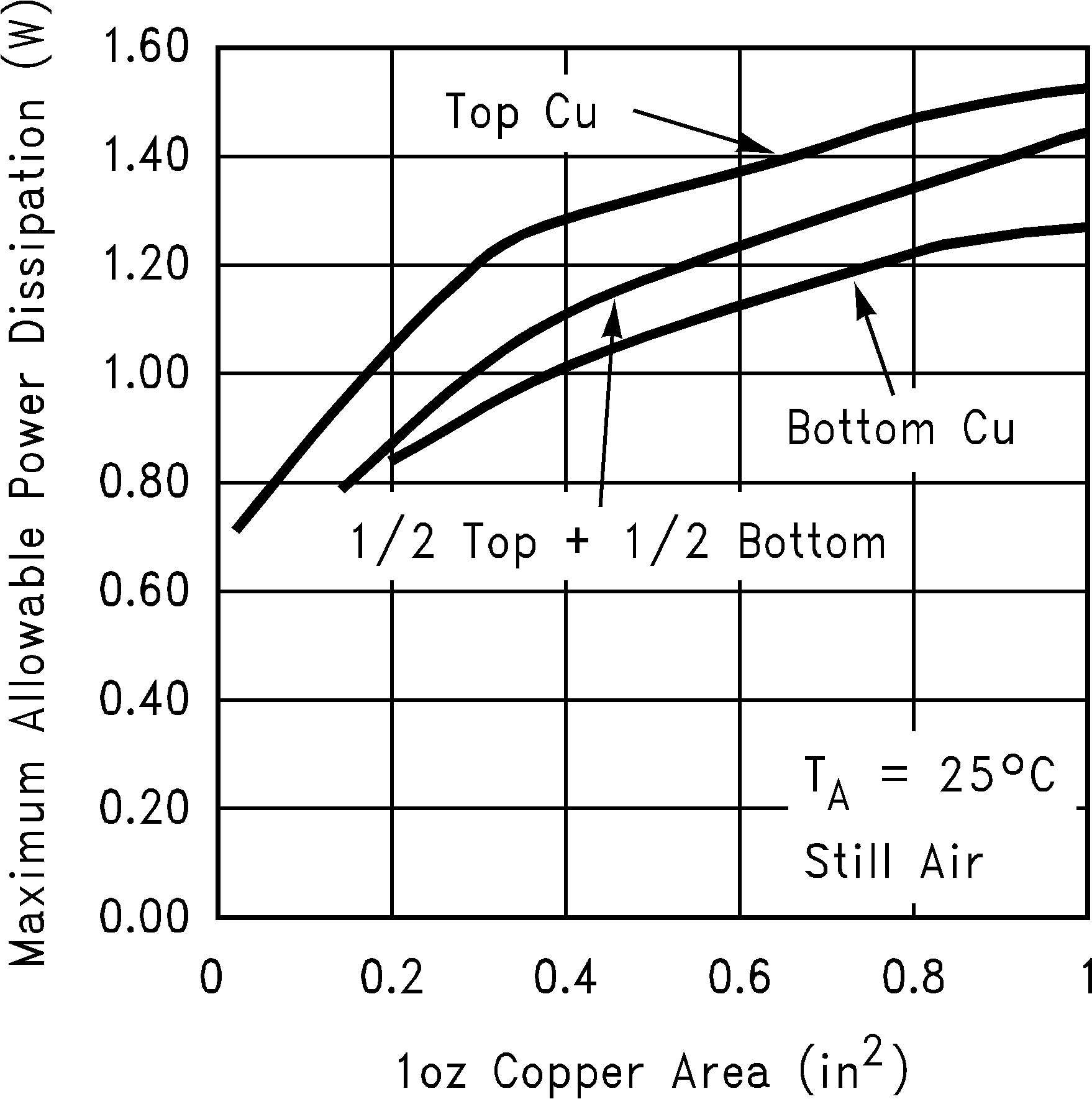 図 9-15 SOT-223 で銅箔部分が 1 オンスのときの最大許容消費電力
図 9-15 SOT-223 で銅箔部分が 1 オンスのときの最大許容消費電力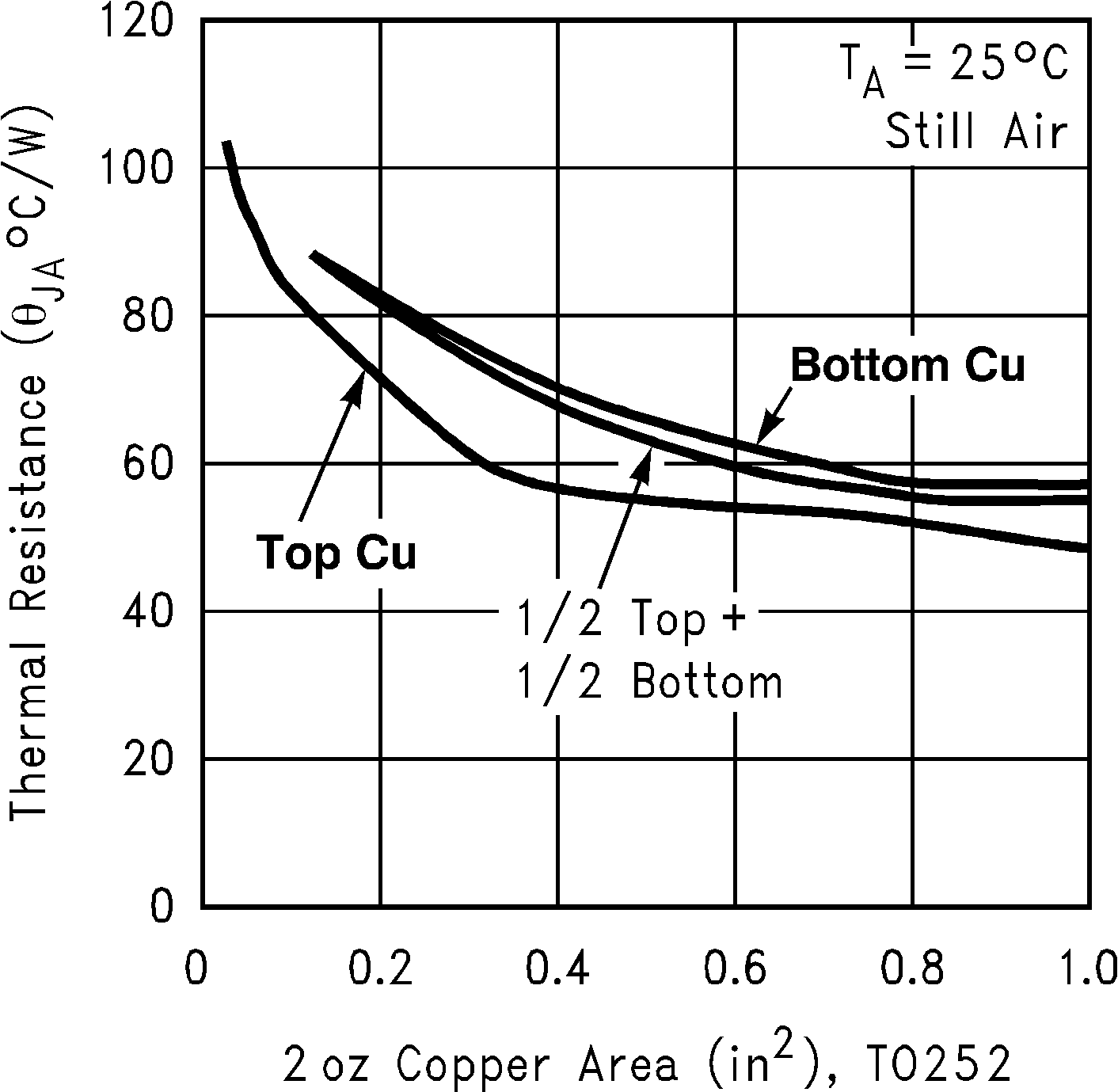 図 9-12 TO-252 で銅箔部分が 2 オンスのときの RθJA
図 9-12 TO-252 で銅箔部分が 2 オンスのときの RθJA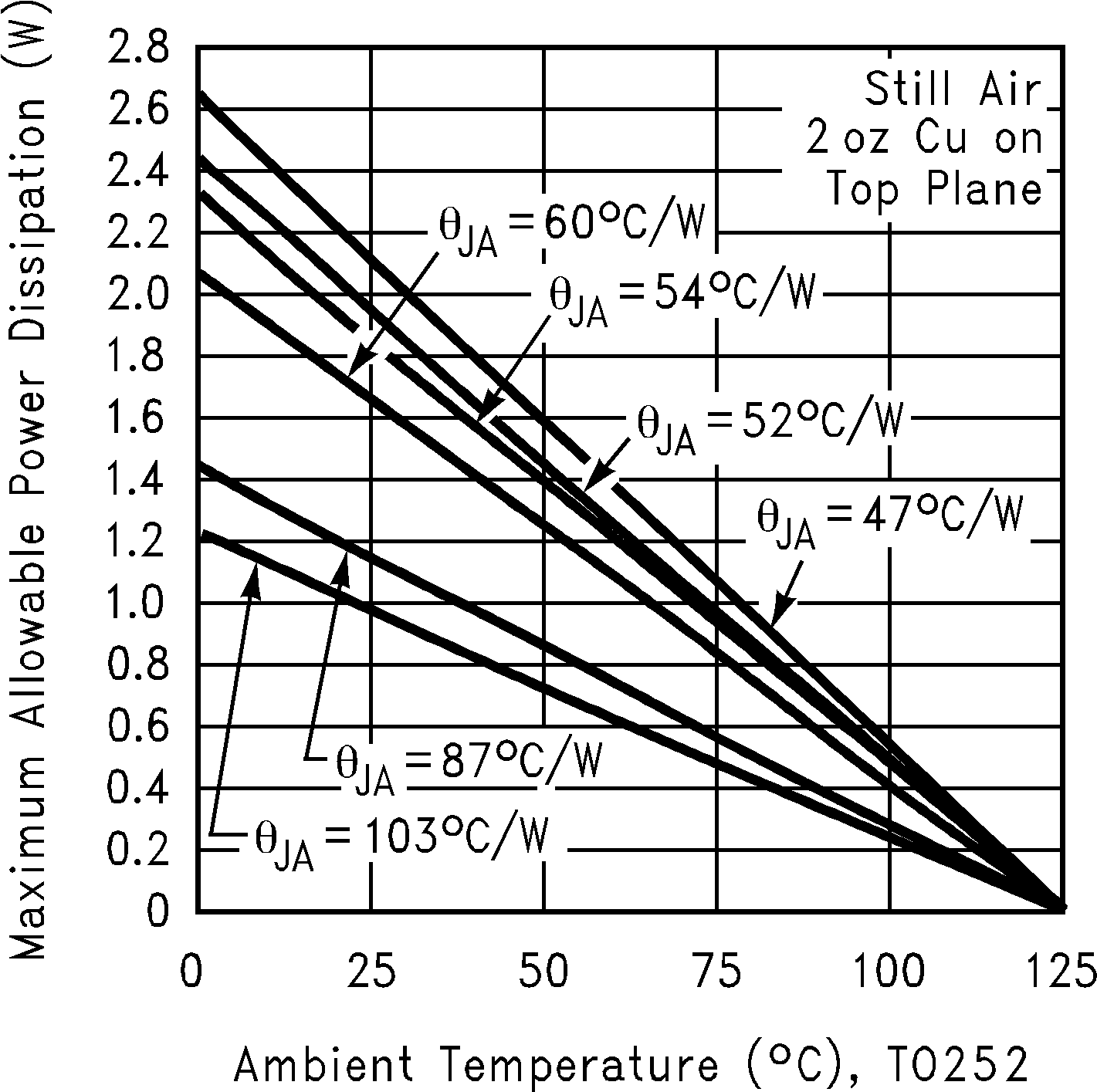 図 9-14 TO-252 の最大許容消費電力と周囲温度との関係
図 9-14 TO-252 の最大許容消費電力と周囲温度との関係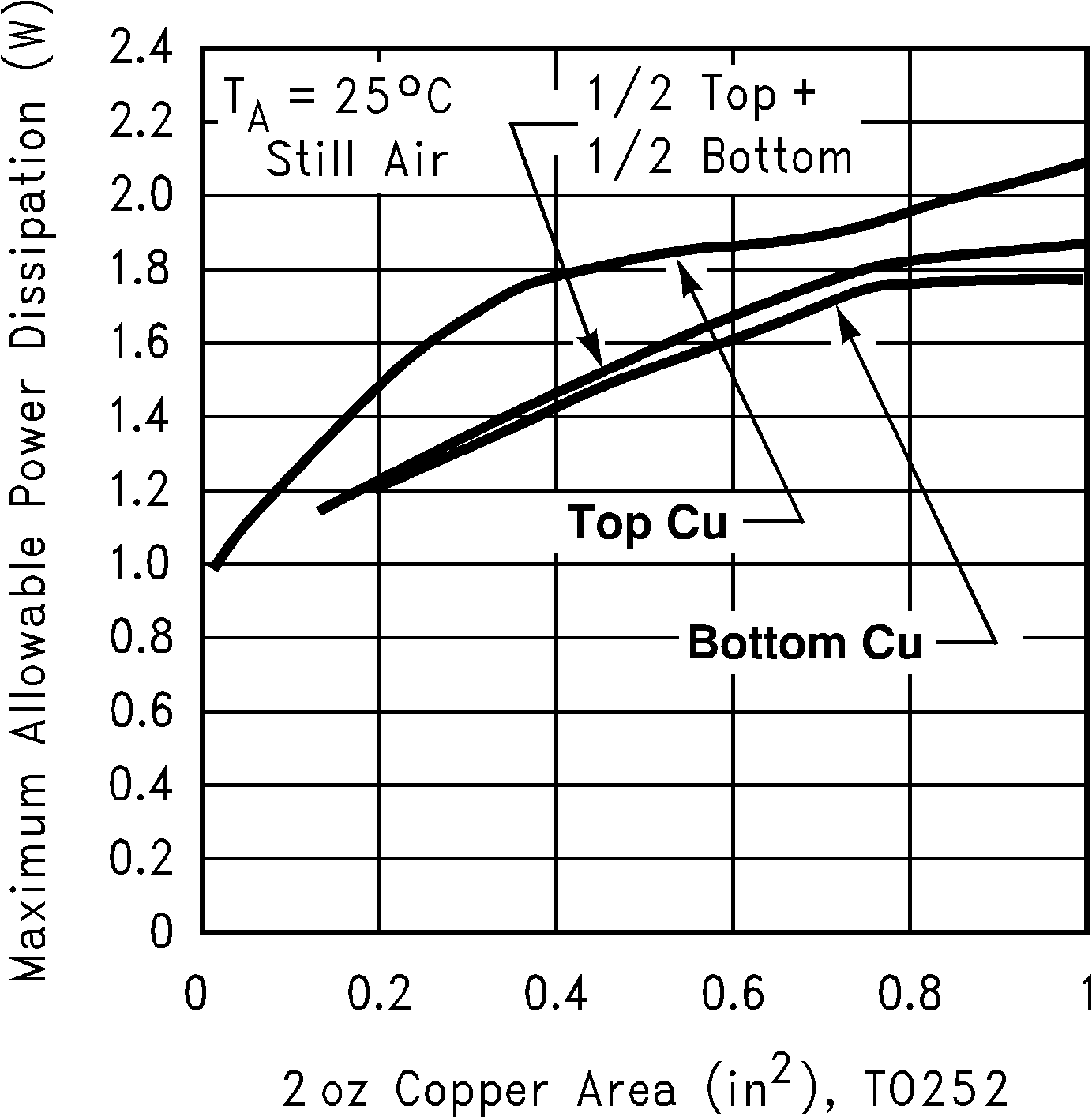 図 9-16 TO-252 で銅箔部分が 2 オンスのときの最大許容消費電力
図 9-16 TO-252 で銅箔部分が 2 オンスのときの最大許容消費電力 図 9-17 熱テスト・パターンの実物大の上面図
図 9-17 熱テスト・パターンの実物大の上面図 図 9-18 熱テスト・パターンの実物大の底面図
図 9-18 熱テスト・パターンの実物大の底面図