JAJA699 November 2020 LM61460-Q1 , LM63615-Q1 , LM63625-Q1 , LM63635-Q1 , LMR33620-Q1 , LMR33630-Q1
4 パッケージ・タイプ
パッケージのタイプは、放熱性能に大きな影響を与えます。この説明では、パッケージをパッケージの下部にダイ・アタッチ・パドル (DAP) があるものと、そうでないものの 2 つの主要なグループに分けています。もちろん、パッケージと他の多くの重要な機能には、さらに多くの違いがありますが、この違いは熱の観点から最も重要なものです。図 4-1 が示すように、LMR33630 は HSOIC とフリップチップ (または HotRod ™) の両方の QFN パッケージで供給されることはその一例です。
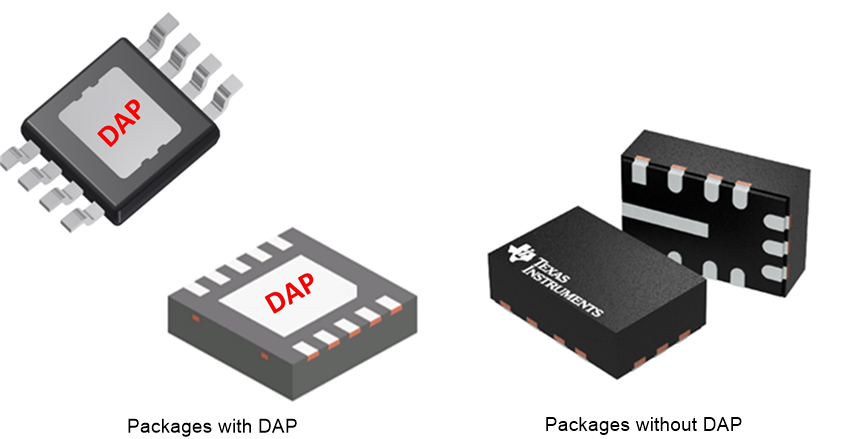 図 4-1 LMR33630-Q1 パッケージのバリアント.
図 4-1 LMR33630-Q1 パッケージのバリアント. このデバイス・ファミリでは、図 4-2 が 2 つのパッケージ間の θJA 内の差を示しています。この値は JEDEC 標準ボードに基づいており、HSOIC パッケージの熱抵抗値が大幅に低いことが容易に分かります。また、トレードオフも明らかです。この例では、HSOIC パッケージは、フリップチップ QFN の面積の 3 倍を超えています。また、QFN パッケージは、ピンが完全に露出している大型パッケージよりも PCB への組み付け時に注意が必要です。図 4-3 と 図 4-4 を参照すると、これらの 2 つのパッケージ例の間の熱抵抗の違いを簡単に説明できます。HSOIC には、大型の金属製の DAP があり、レギュレータ・ダイに直接取り付けられています。また、DAP は、PCB の銅製ヒートシンクに半田付けされています。これにより、ダイ (熱発生源) からヒートシンクと外気温への非常に抵抗の低い経路が得られます。その結果、熱の約 80%が DAP を通過し、20%がリード線を通り、プラスチックを通るのはごくわずかとなります。これにより、DAP 下側の銅 (通常は電気的なグランド) がパッケージの熱を除去するのに非常に効果的になります。
フリップチップ・パッケージでは、ダイ (またはサブストレート) の背面が PCB から離れて上向きになります。PCB への金属的な接続はパッケージ・ピンを通過してのみ行われます。これにより、熱が通過する経路が非常に制限されることを余儀なくされ、有効な熱抵抗が増加します。また、これは、ヒートシンクとしての機能を実現するため、ピンへの銅経路はできるだけ大きくする必要があることも示しています。DC/DC コンバータの場合、VIN、GND、および SW ピンは放熱効果がきわめて高いので、幅広くしておくべきです。
もちろん、これらは設計者が利用できる各種電源パッケージのうち、わずか 2 例にすぎません。テキサス・インスツルメンツでは、優れた放熱性能と小型サイズの両方のメリットを実現するさまざまなパッケージ・タイプをご用意しています。車載認証済みの LM63635-Q1 はその一例です。このデバイスは、DAP を持つ小型の 3.00mm × 3.00mm WSON パッケージで提供され、より大型のパッケージと同等の性能を実現します。
JEDEC 標準ボードは、フリップチップ QFN と HSOIC の違いを過剰に強調しているので注意してください。実際の多くのアプリケーションでは、この 2 つのパッケージの間で全体的な θJA の値を比較できます。フリップチップ QFN の場合、DAP を持つパッケージに比べ、より多くの PCB 銅箔部分が必要になります。いずれの場合でも、上記のように、表記載の θJA の値は、設計目的には使用できません。
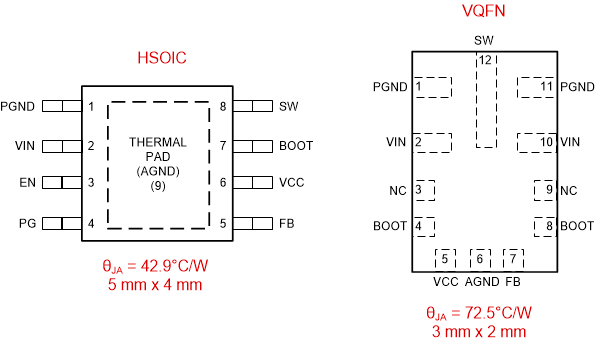 図 4-2 HSOIC と VQFN の性能の比較.
図 4-2 HSOIC と VQFN の性能の比較. 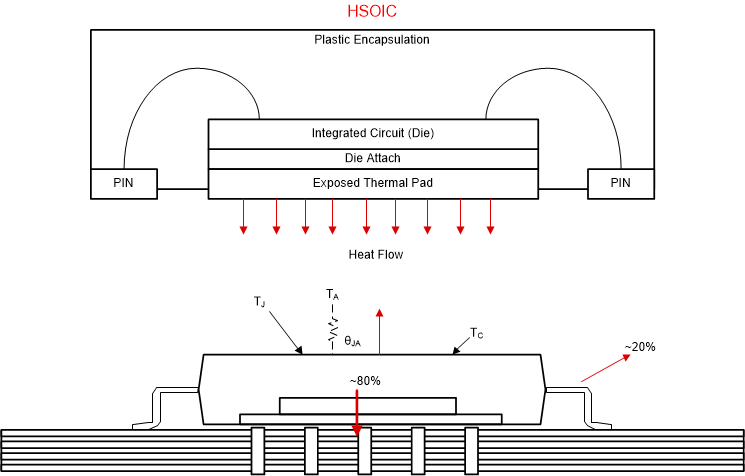 図 4-3 HSOIC パッケージ内の標準的な熱フロー.
図 4-3 HSOIC パッケージ内の標準的な熱フロー. 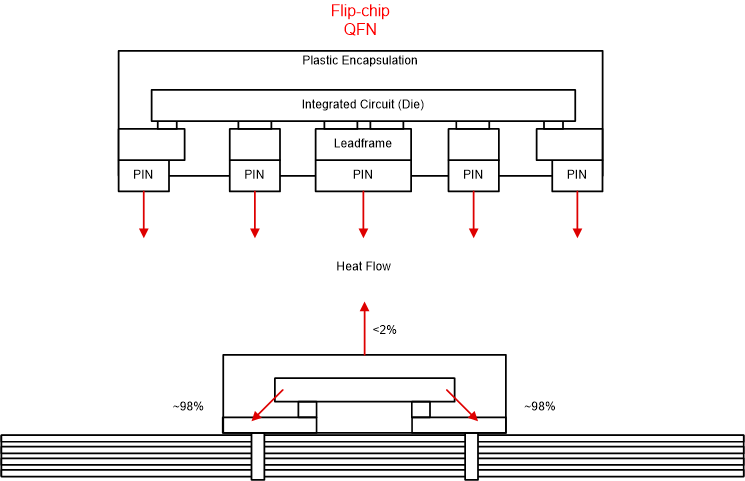 図 4-4 VQFN パッケージ内の標準的な熱フロー.
図 4-4 VQFN パッケージ内の標準的な熱フロー.