KOKY024C january 2023 – april 2023 LMQ61460-Q1 , TPS54319 , TPS62088 , TPS82671 , UCC12040 , UCC12050
패키지 열 혁신
IC(통합 회로) 패키지에서 열을 없애는 기술은 전력 밀도에 직접 영향을 미칩니다. 이전에 언급했듯이, 이는 패키지가 계속해서 작아짐에 따라 더욱 중요한 문제가 되고 있습니다. 더욱이 일반적인 전력 컨버터에서 반도체 장치는 솔루션에서 가장 뜨거운 부분이 되는 경우가 많으며, 이는 Rsp가 급격하게 줄어들면 더 심해집니다.
TI는 일반적인 본드 와이어 유형 QFN(Quad Flat No Lead) 패키지를 플립 칩 스타일 패키지로 대체하는 HotRod™ 패키지의 개발 및 도입에 투자했습니다. 그림 9 및 그림 10은(는) HotRod QFN이 어떻게 QFN과 유사한 풋프린트를 유지하면서 본드 와이어를 제거하는지를 보여줍니다. 이를 통해 일반적으로 플립 칩 패키지에서 기생 루프 인덕턴스가 크게 감소하고, QFN 패키지 열 성능의 이점을 유지할 수 있습니다. HotRod QFN에는 리드 프레임과 다이를 상호 연결하는 기능이 포함되어 있습니다.
 그림 9 노출된 패드가 있는 표준 본드 와이어 QFN
패키지.
그림 9 노출된 패드가 있는 표준 본드 와이어 QFN
패키지. 그림 10 HotRod 상호 연결 패키지(플립 칩 온 리드)
QFN 패키지.
그림 10 HotRod 상호 연결 패키지(플립 칩 온 리드)
QFN 패키지.HotRod 패키지의 한 가지 문제는 패키지 열 개선에 매우 유용한 대형 DAP(다이 부착 패드)를 제작하기 더욱 어렵다는 점입니다. 이 문제를 극복하기 위해 TI는 최근 HotRod QFN을 개선하여 기존 장점을 유지하면서 동시에 대형 DAP가 포함된 패키지를 내놓았습니다.
그림 11, 그림 12 및 그림 14은(는) 열 성능을 향상시키기 위해 이러한 기술을 포함한 4-A LM60440 동기 컨버터를 보여줍니다. 패키지 중앙에 대형 DAP가 들어갈 정도의 풋프린트가 확보되는 것을 볼 수 있습니다. 이 DAP는 이전 세대와 비교할 때 약 15%의 온도 증가 관련 이점을 제공합니다. 이러한 패키지의 진화에 대한 자세한 내용은 아날로그 설계 학술지 문서 소형 DC/DC 컨버터를 사용한 설계에서 알아볼 수 있습니다. HotRod™ QFN과 향상된 HotRod™ QFN 패키징.
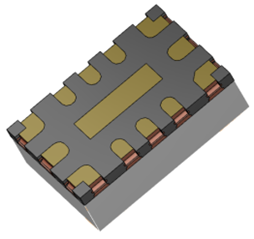 그림 11 대형 DAP를 지원하는 개선된 HotRod
QFN.
그림 11 대형 DAP를 지원하는 개선된 HotRod
QFN. 그림 12 개선된 HotRod QFN의 LM60440의
핀아웃.
그림 12 개선된 HotRod QFN의 LM60440의
핀아웃.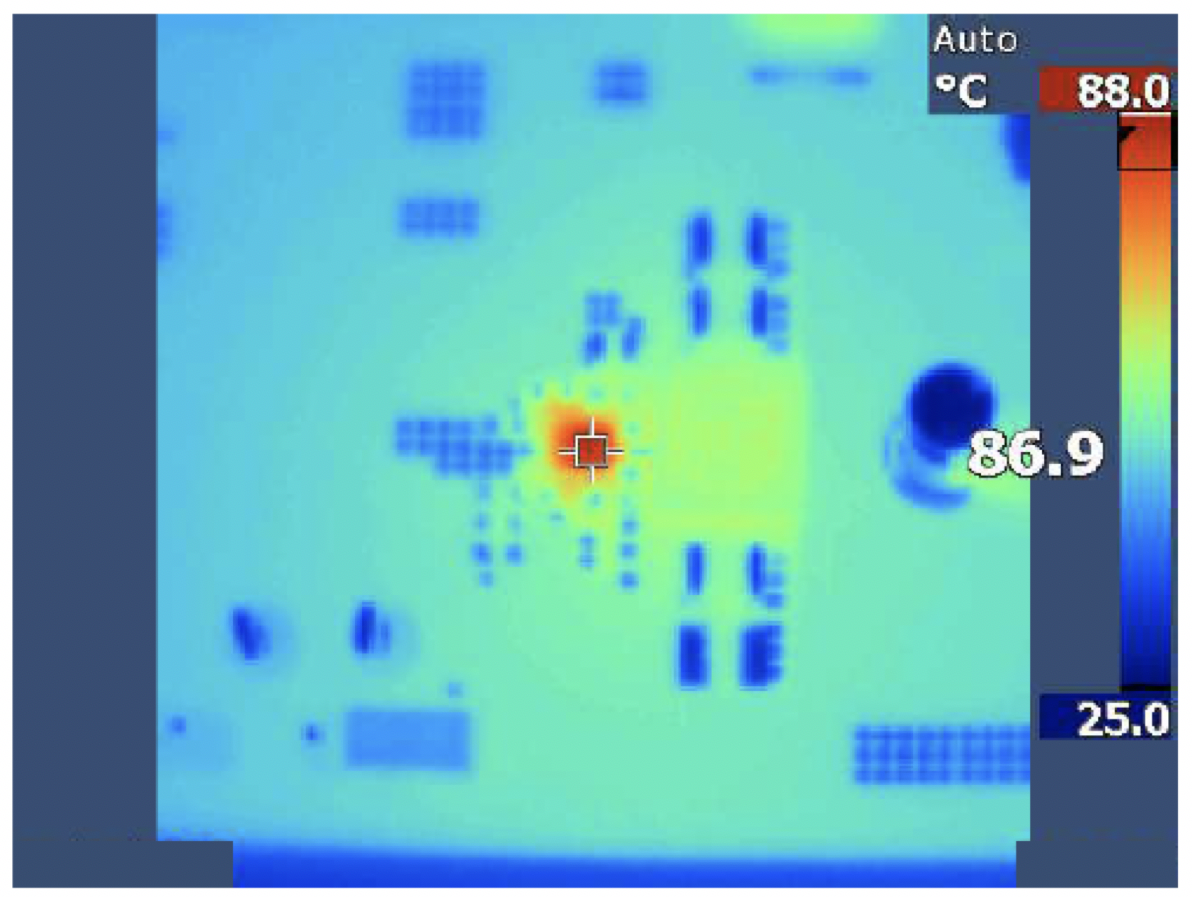 그림 13 일반 HotRod 패키지의 열 성능.
그림 13 일반 HotRod 패키지의 열 성능. 그림 14 향상된 HotRod QFN 패키지에 DAP를 포함한
LM60440의 열 성능으로 평균 온도는 71.1°C로 낮아집니다.
그림 14 향상된 HotRod QFN 패키지에 DAP를 포함한
LM60440의 열 성능으로 평균 온도는 71.1°C로 낮아집니다.또한 많은 설계자는 SOT(small-outline transistor) 표면 실장 패키지를 활용하는 것을 선호하는데, 이는 비용이 저렴하고 핀 리드를 조립하기 쉽기 때문입니다. TI는 향상된 공정 기술 및 회로 IP를 SOT-563 패키지와 결합하여 로우 프로파일, 이중 행 핀 구성이 더 높은 전류 밀도에 대한 요구를 충족할 수 있도록 합니다. TPS566242 3V~16V 동기식 벅 컨버터가 최근의 한 예입니다. 이 장치는 1.6mm x 1.6mm SOT-563(6핀) 풋프린트에서 98% 듀티 사이클로 최대 6A의 연속 전류를 지원합니다.
마찬가지로 WCSP(웨이퍼 칩 스케일 패키지) 사용 시 대부분의 열은 범프에서 직접 PCB로 전도됩니다. WCSP의 범프 영역이 커지면 열 성능이 개선됩니다. TI는 최근 PowerCSP™ 패키징을 개발하여 출시했습니다. 이는 WCSP의 일반적인 원형 범프를 대형 솔더 바로 대체하여 패키지 열과 전기 성능을 개선하는 것을 목표로 합니다. 그림 15은(는) TPS62088에서 이 기술을 구현하는 예시를 보여줍니다. 그림 15은(는) 표준 WCSP를 보여주며, 그림 16은(는) PowerCSP 패키징이 포함된 동일한 장치를 보여줍니다. 별도의 시스템 변경 없이도 온도 증가가 약 5% 감소합니다.

| VIN = 5V | VOUT = 1.8V |
| IOUT = 3 A | TA = 25°C |
| 측정 지점: Bx1 |
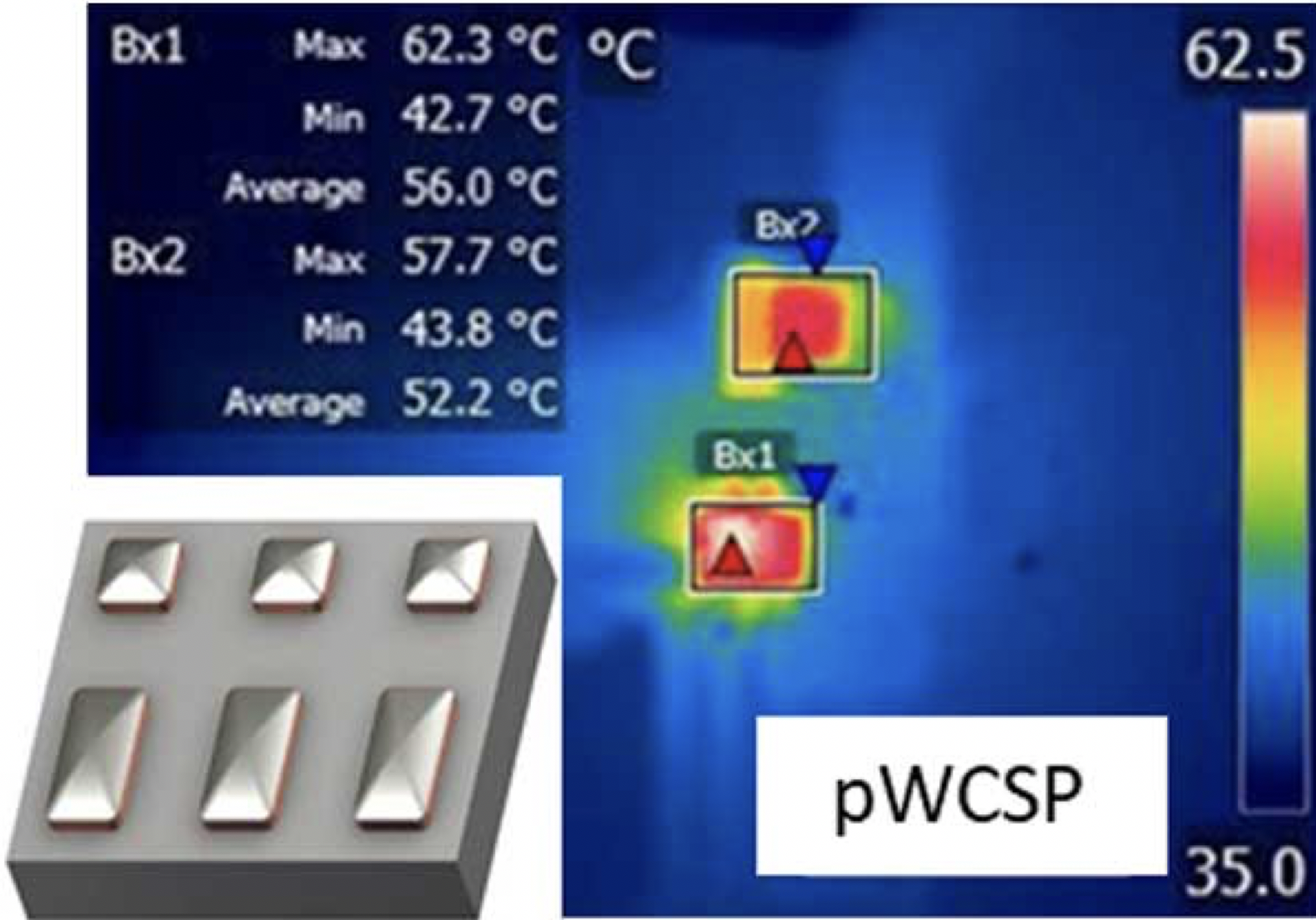
| VIN = 5V | VOUT = 1.8V |
| IOUT = 3 A | TA = 25°C |
| 측정 지점: Bx1 |