SNOAA68 June 2021 LMG3410R050 , LMG3410R070 , LMG3410R150 , LMG3411R050 , LMG3411R070 , LMG3411R150 , LMG3422R030 , LMG3422R050 , LMG3425R030 , LMG3425R050 , LMG3522R030-Q1 , LMG3526R030
4 Achieving Lifetime Reliability
TI has engineered GaN products for lifetime reliability through an extensive program, completing over 40 million hours of reliability testing as of November 2020. We realized at an early stage that traditional silicon qualification was not testing for hard switching, nor detecting the GaN-specific failure mode of dynamic RDS(ON), so we built our reliability program to address GaN specific needs.
TI GaN products consist of both a GaN chip and a Si IC chip integrated in a Multi-Chip Module (MCM) package using a low-inductance leadframe. Our program ensures reliability of both the individual die and the final product using the methodology of Figure 1-1. These tests are listed in Table 4-1 at both technology and product level. The Si chip integrates the driver and additional protection functions. It is built on an established TI Si platform also used for many silicon IC products. The GaN chip is built using TI’s GaN technology platform. Qualification is conducted at multiple levels, first at the technology level on both GaN and Si platforms, then in the final product. The battery of qualification testing includes both traditional and GaN-specific JEDEC testing. It also includes the testing of the product under extreme conditions.
| Intrinsic Reliability | Product Reliability | |
|---|---|---|
| Technology-level | Regular operation | Extreme operation |
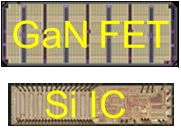 |  |  |
|
|
|
Both technology platforms and the final product are qualified to the JEDEC JESD47 standard. Automotive qualification is per AEC Q-100. For the technology platform, device reliability (TDB) and electromigration are per JEDEC JEP122 and dynamic RDS(ON) measurements are per JEP173. The hard-switching lifetime and product dynamic high temperature operating life (DHTOL) are per JEDEC JEP180 and JEP182. The product is also tested under extreme conditions for surge and short-circuit robustness.